AMAT 64-81813-00
Product Introduction:
This is a high-precision heating assembly, often integrated into the electrostatic chuck or wafer pedestal. It uses resistive heating elements embedded within a ceramic body (usually Aluminum Nitride for high thermal conductivity) to heat the wafer to processing temperatures ranging from room temperature to several hundred degrees Celsius.
Technical Specifications:
- Core Material: Aluminum Nitride (AlN) or Alumina.1.
Detailed content
- Heating Element: Tungsten or Molybdenum resistive traces.
- Power Rating: 1000W to 3000W depending on size.
- Temperature Uniformity: ±1°C to ±3°C across the wafer surface.
- Thermocouples: Embedded RTDs or Thermocouples (Type K/C) for closed-loop control.
- Lifetime: Designed for high thermal cycling durability.
Functional Features:
- Rapid Thermal Processing (RTP): Capable of fast ramp-up and cool-down rates.
- Uniform Heating: Ensures consistent film growth or etch rates across the wafer.
- Process Compatibility: Resistant to chemical attack from process gases.
- Safety: Includes over-temperature protection sensors.
Application Scenarios:
- CVD Processes: Critical for LPCVD and PECVD where temperature dictates film quality and stress.
- Annealing: Used for post-implant or post-deposition annealing.
- Etch Processes: Used to control etch chemistry kinetics which are temperature-dependent.
- Main Equipment: Applied Materials Rapid Thermal Processing (RTP) chambers, furnace tubes, and heated pedestals.





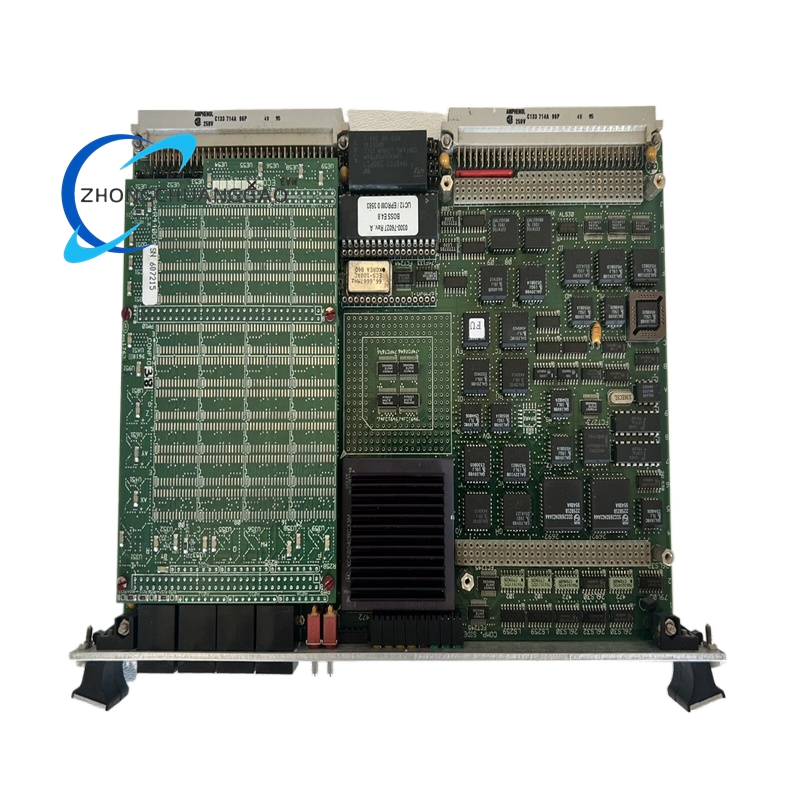
.jpg)





