AMAT 0050-81422
Product Introduction:
The Electrostatic Chuck is the heart of the wafer handling system in plasma processors. It holds the wafer securely in place using electrostatic force (Johnsen-Rahbek or Coulomb force) generated by high voltage DC. It also typically incorporates a helium backside cooling system to control the wafer temperature during high-power processing.
Technical Specifications:
- Type: Johnsen-Rahbek (JR) or Coulomb.
- Material: Aluminum Nitride (AlN) or Alumina (Al2O3) ceramic.
Detailed content
- Clamping Voltage: 0V to 2000V DC (typically).
- Cooling: Helium backside gas cooling channels.
- Electrodes: Embedded monopolar or bipolar electrodes for RF biasing.
- Temperature Range: -20°C to 400°C+ (depending on heater integration).
Functional Features:
- Wafer Clamping: Holds the wafer firmly without mechanical clamps, allowing full surface processing.
- Temperature Control: Precise control of wafer temperature via embedded heaters and He gas pressure.
- RF Biasing: Allows independent control of DC self-bias to tune ion energy without affecting plasma density.
- Endpoint Detection: Some ESCs integrate optical sensors for endpoint detection.
Application Scenarios:
- High-Power Etch: Essential for holding wafers during high-density plasma etching.
- PVD Sputtering: Holds wafers during metal deposition.
- Ion Implantation: Holds wafers at specific angles and temperatures.
- Main Equipment: Applied Materials Super E, Kiyo, Exelan, and Centura platforms.







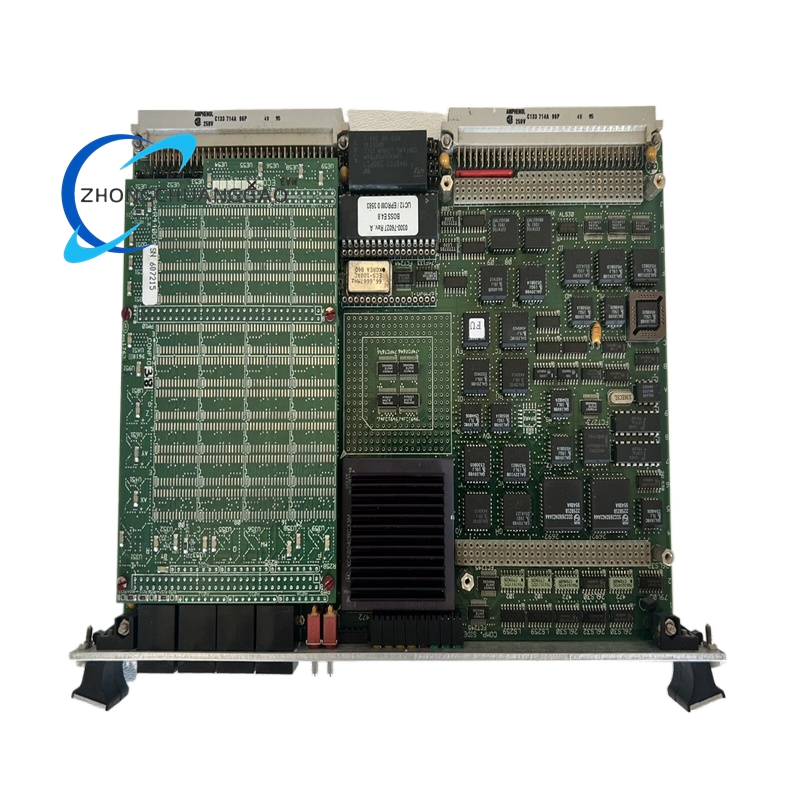

.jpg)
.jpg)


