AMAT 0041-12339 Plasma Process Electrode Assembly
Product Overview: The AMAT 0041-12339 is a high-performance plasma process electrode assembly designed for use in the plasma generation and processing modules of Applied Materials semiconductor equipment. It is a critical component that directly participates in plasma excitation, ion acceleration, and wafer surface processing, playing a key role in determining the quality and uniformity of semiconductor thin films and etched features. This electrode assembly is engineered with high-purity materials and advanced coating technology to withstand the harsh plasma environment, ensuring long-term stability and consistent process performance.
Technical Specifications: – Material Composition: Electrode core made of high-purity graphite (99.999% purity) or silicon carbide (SiC) for excellent thermal conductivity and plasma resistance; surface coating: TiN (titanium nitride) or Al₂O₃ (aluminum oxide) coating (thickness: 5-10 μm) for enhanced wear resistance and plasma erosion resistance.
Detailed content
– Dimensions: Diameter: 150mm (standard), thickness: 20mm, with a precision-machined surface (surface roughness ≤ 0.2 μm) to ensure uniform plasma distribution. – Electrical Parameters: Impedance: 50 Ω (matched to RF power supply), maximum RF power handling: 3000W (continuous wave), operating frequency: 13.56 MHz (standard) or 27.12 MHz (optional). – Thermal Performance: Thermal conductivity: ≥ 150 W/m·K (graphite core), operating temperature: up to 800°C, with a thermal expansion coefficient of 4.5×10⁻⁶ /°C (20-500°C). – Compatibility: Compatible with AMAT’s RF power supply systems and process gases (e.g., Ar, O₂, CF₄, Cl₂). – Service Life: ≥ 5000 process hours under standard plasma conditions, depending on process parameters. – Certification: Complies with SEMI S2/S8 safety standards and ISO 9001 quality control requirements.
Functional Features: – Excites and sustains plasma in the process chamber by applying RF power, generating high-energy ions and radicals for wafer processing. – Controls ion energy and distribution, ensuring uniform etching or deposition across the entire wafer surface (uniformity: ±3% across 300mm wafers). – Enables precise control of process parameters (e.g., plasma density, ion energy) to achieve the desired feature size and film thickness. – Resists plasma erosion and chemical attack, minimizing material loss and particle generation during processing. – Maintains stable electrical performance over time, preventing RF arcing and ensuring consistent process results. – Features a heat-dissipating design to transfer heat away from the electrode surface, preventing overheating and component damage. – Compatible with AMAT’s process control system, allowing for real-time adjustment of electrode parameters to optimize process performance.
Application Scenarios: – Widely used in AMAT’s dielectric etching (DE), metal etching (ME), and plasma-enhanced chemical vapor deposition (PECVD) systems. – Installed as a top electrode, bottom electrode, or focus ring in the process chamber of semiconductor processing equipment. – Applied in the manufacturing of logic chips, memory chips (DRAM, NAND), and advanced packaging components (e.g., flip-chip, wafer-level packaging). – Suitable for 200mm and 300mm wafer processing, including advanced technology nodes (≤7nm). – Ideal for high-volume semiconductor production lines, where process uniformity, component reliability, and long service life are critical. – Used in research and development laboratories for developing new plasma processing technologies and optimizing existing processes.







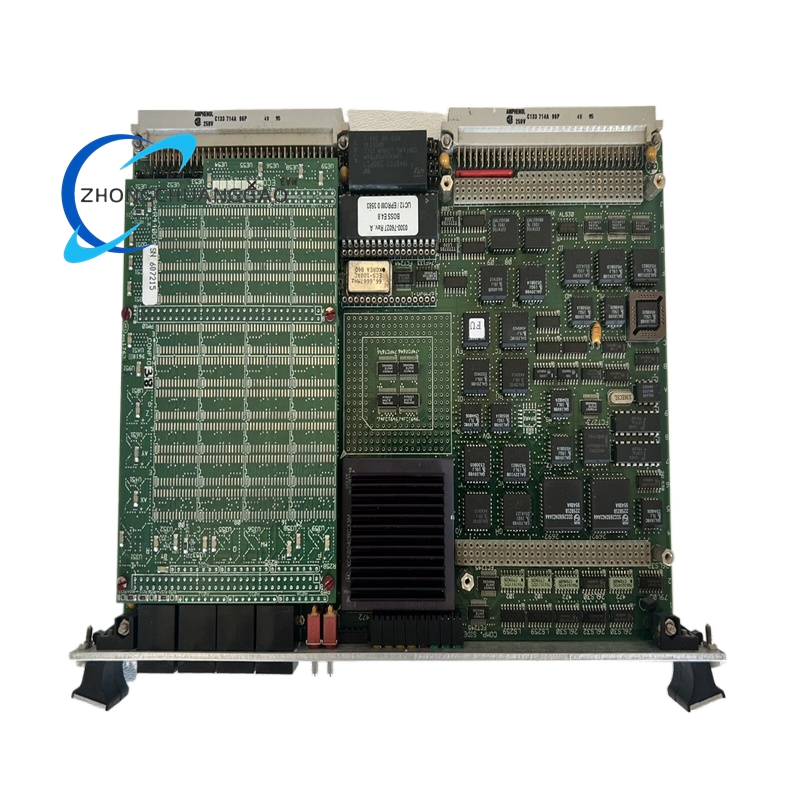

.jpg)



