AMAT 0021-01996
Product Name: Sputtering Target Assembly (Bonded Type)
Product Introduction:
This is the source material for Physical Vapor Deposition (PVD). The target is the material that is bombarded by ions, causing atoms to be ejected (sputtered) and deposited onto the wafer. This specific part number likely refers to a “bonded” target, where a thin layer of the expensive functional material (e.g., Copper, Tantalum) is bonded to a backing plate (usually Copper or Aluminum) using a diffusion bonding or soldering process. The backing plate provides structural support and acts as a heat sink to prevent the target from melting during high-power sputtering.
Detailed content
Technical Specifications:
- Target Material: Can include Cu, Al, Ti, Ta, W, TiN, TaN, Co, or alloys.
- Purity: Typically 99.999% (5N) or higher for critical layers.
- Dimensions: Custom diameter and thickness (e.g., 300mm diameter, 6mm thick) with a machined groove for the backing plate.
- Backing Plate: Oxygen-Free High-Conductivity (OFHC) Copper or Aluminum alloy; includes water cooling channels.
- Bonding Method:
- Indium Soldering: For low-temperature processes (Target melting point < 300°C).
- Diffusion Bonding: High-temperature/high-pressure process for refractory metals.
- Surface Finish: Machined to flatness < 0.005 inches; surface roughness < 32 micro-inches.
Functional Features:
- High Thermal Conductivity: The backing plate efficiently removes heat from the target face, preventing warping and increasing target life.
- Grain Structure Control: For some materials (like Aluminum), the target grain size is controlled to influence the deposited film’s grain structure and electromigration resistance.
- Erosion Profile: The target is designed with a specific shape (e.g., cylindrical or planar) to ensure uniform erosion (“racetrack”) to maximize material utilization (typically 70-80%).
- Low Impurity: The bonding material and process are chosen to minimize contamination of the sputtered film.
- Magnetron Compatibility: Designed to work with stationary or rotating magnetron assemblies to confine the plasma over the target surface.
Application Scenarios:
- Copper Interconnects: Sputtering Cu seed layers for electroplating in damascene processes.
- Barrier/Seed Layers: Sputtering Ta/TaN or Ti/TiN to prevent copper diffusion into the dielectric.
- Magnetic Layers: Sputtering Permalloy (NiFe) or Cobalt-based alloys for MRAM or hard drive heads.
- Hard Coatings: Sputtering Titanium Nitride (TiN) for wear resistance on tools or as a gold-colored decorative coating.
- Optical Films: Sputtering SiO2 or TiO2 for anti-reflective coatings.








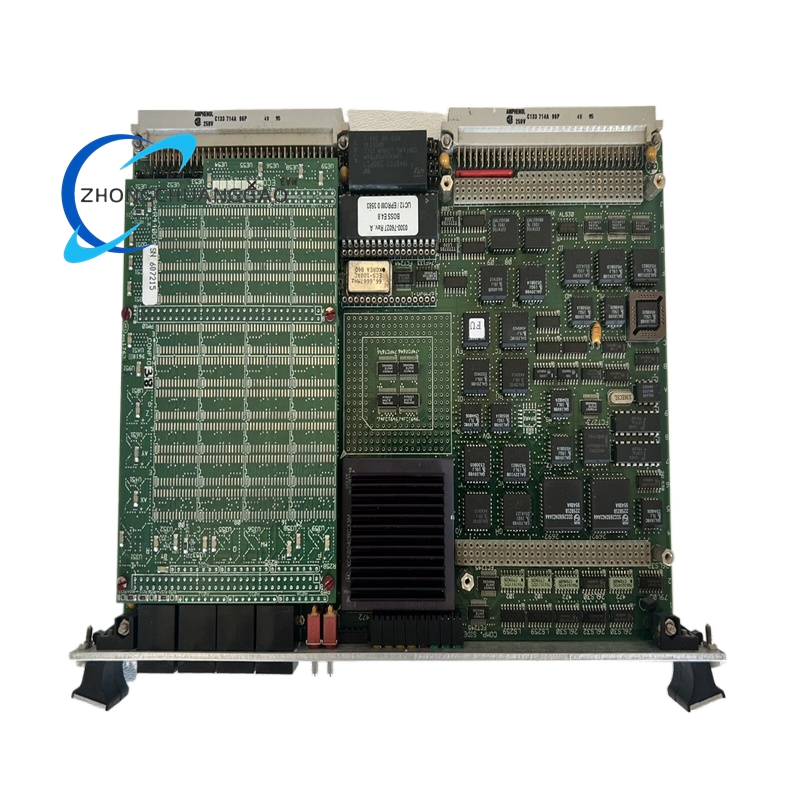


.jpg)

